
扫码加微信

热门关键词:展至科技 氧化铝陶瓷基板/支架 氮化铝陶瓷基板/支架 陶瓷覆铜板 陶瓷电路板
随着国内外LED行业向高效率、高密度、大功率等方向发展,从2016到2019就能看出,整体国内LED有了快速发展,如今功率也是越来越大,在开发性能优越的散热材料已经成为LED散热问题的解决,也是当务之急。为了使LED结温保持着较低温度下,然而必须采用高导热率、低热阻的散热基板材料和合理的封装工艺,从而以降低LED总体的封装热阻。
如今现代通讯技术的发展,在多层陶瓷基板上凭借着其灵活布线、三维集成等优势广泛应用于航空航天、卫星通讯等射频领域。为了实现电子整机向高密度,小型化,轻量化的方向发展,现在越来越多的电路组件使用多层陶瓷基板一体化封装技术来实现模块化和器件化。

研究AIN多层陶瓷基板一体化封装技术,AIN多层陶瓷相比较于低温共烧陶瓷和AI2O3共烧陶瓷来讲,其中导热系数高,热膨胀系数和Si更接近。
在伴随着电子设备的集成度大幅提高,电路中单位面积所散发出来的热量不断增大,系数对散热要求也越来越高。
AIN一体化封装工艺结构
1、AlN基板制备流程
AIN多层陶瓷基板制备流程与传统低温共烧陶瓷工艺流程基本一致,由于材料体系和成分差别,与个别工艺略有不同。在实验陶瓷材料采用厚度为0.13mm高纯氮化铝膜带,通孔金属浆料和印刷浆料均选择高温烧结钨浆,一般AlN烧结需要在还原气氛下进行;排胶和烧结是AlN多层陶瓷基板制备流程中的关键工序,影响着基板的翘曲、开裂等,直接决定了多层板的性能和质量。陶瓷基板表面共烧的钨浆无法直接进行焊接、键合且极易氧化,需要在表层进行化镀镍钯金进行后续装配。
2、AlN一体化封装结构
AlN多层陶瓷基板的一体化封装主要由以下几部分组成:AlN多层陶瓷基板,围框和盖板,具体结构如图1所示。
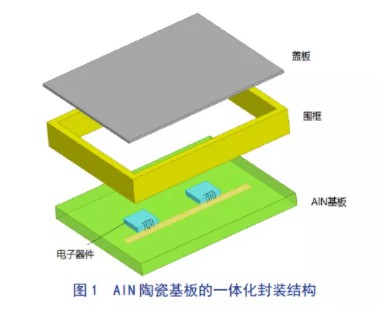
围框一般采用焊接温度较高的焊料与基板焊接,对于整体结构而言,围框材质的热膨胀系数需要与基板热膨胀系数接近,以防在焊接时热应力失配造成产品开裂。盖板与围框多采用平行缝焊的方式进行气密封装。
氮化铝陶瓷基板一体化封装工艺流程
1.一体化封装材料 2.围框焊接及测试 3.气密封焊及测试
